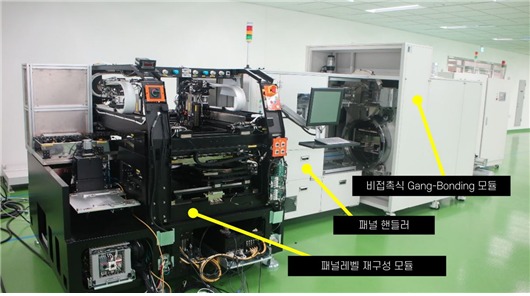 © 뉴스1
© 뉴스1갱 본더 장비는 머리카락 한 가닥(약40~70㎛)의 절반보다 얇은 20㎛급 유연 반도체 칩을 파손 없이 고집적 유연기판에 배열하고, 조립정밀도 ±2㎛ 이내로 접속 및 적층시킬 수 있는 대면적 규모의 패널 레벨 패키지 조립 장비다.
연구팀은 갱 본더 방식의 패키징을 구현하기 위해 특수 기체를 이용하여 칩과 접촉하지 않고 압력을 인가하는 기술을 개발했다.
현재 반도체 패키징 조립은 개별 칩마다 조립 헤드부분이 기계적으로 압력을 가하는 방식으로 이뤄진다. 이때 칩과 기판의 두께에 편차가 생기면 조립 오차가 발생할 수 있어 한 번에 만들 수 있는 양에 제한이 있었다.
이밖에 연구팀은 300㎜×300㎜ 이상의 대면적을 20℃/sec 이상으로 고속 승온 및 냉각할 수 있는 다중 셀 세라믹 히터(온도 균일도 ±2% 이내)를 개발했다.
이 시각 인기 뉴스
이는 유연 기판을 셀로 나눠 가열하되, 이를 동시에 진행해 균일한 열전달을 가능하게 하는 기술이다.
송준엽 부원장은 “갱 본더 장비는 유럽, 일본 등 반도체 장비 선도국가의 소수 업체가 주도하고 있는 최고 사양의 반도체 조립 장비보다 앞선 세계 최고 수준의 기술”이라고 말했다.
이어 “웨어러블 디바이스, 스마트카드, 메디컬 디바이스, Micro-LED 디스플레이뿐만 아니라 AI 반도체 패키지와 같은 웨이퍼 및 패널 레벨 패키지 초정밀 조립 분야에도 활용될 수 있어 관련 산업의 고속 성장에 따라 새로운 장비산업 창출로 확대될 것으로 기대된다”고 강조했다.
<저작권자 © 뉴스1코리아, 무단전재 및 재배포 금지>
